이차이온질량분석 문의: ☎ 031-299-6764, 홍문규 주임
1. 이차이온질량분석(Secondary Ion Mass Spectrometery) 원리
이차이온질량분석기(SIMS, Secondary Ion Mass Spectrometry)는 일정한 에너지를 가진 일차이온을 고체 표면에 입사시킨 후 방출되어 나오는 이차이온의 잘량을 측정하여 재료 표면을 구성하고있는 원소 및 분자의 종류 그리고 양을 분석하는 장비이다.
입사되는 일차이온의 양(기준: 1013개/cm2)에 따라 기준 보다 적은 SIMS를 정적 SIMS(Static SIMS), 기준 보다 많은 SIMS를 동적 SIMS(Dynamic SIMS)로 구분하며, 비행시간형 이차이온질량분석기(TOF-SIMS, Time-Of-Flight SIMS)는 이중에 정적 SIMS에 해당한다. TOF-SIMS의 경우 표면을 파괴시키지 않으면서 단원자층을 분석할 수 있을 정도 일차이온 전류밀도를 줄여 표면을 구성하고 있는 원소와 분자를 확인할 수 있으며, 질량 범위가 매우 크고 한 번에 수많은 이온을 분석 할 수 있는 장점을 가진다. 분석 방법은 표면분석(Surface Analysis), 깊이분석(Depth Analysis) 2가지가 잇으며 표면 분석으로 표면 Graph(Intensity-Mass), Element 분석, Raw Peak 분석, 2D Mapping이 가능하며 깊이분석으로 Depth Profiling, 3D Mapping이 가능하다.
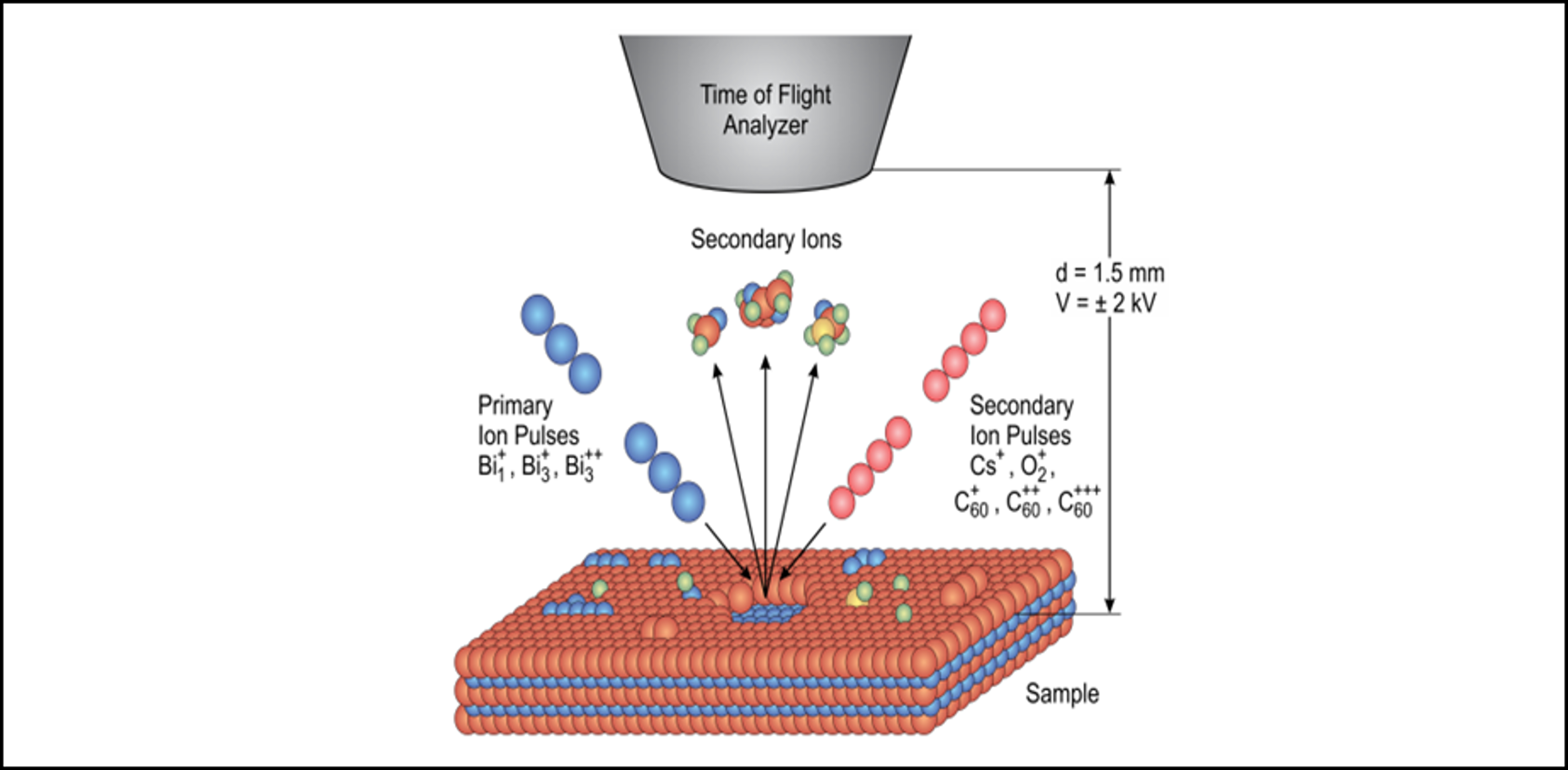
2. 분석종류
| 구분 | 내 용 | 분석 결과 |
|---|---|---|
|
표면분석 |
표면 내 존재하는 이온(원소, 분자)의 종류 |
|
|
2D Mapping |
2D 공간 내 이온의 분포 |
|
|
깊이분석 |
깊이 방향으로의 이온 변화 |
|
|
3D Mapping |
3D 공간 내 이온의 분포 |
|
3. 보유장비 스펙
*장비명을 선택하시면 상세스펙을 확인 할 수 있습니다.
| 장비명 | 단축명 | 모델명 | 기타사항 |
|---|---|---|---|
|
SIMS |
TOF-SIMS-5 |
- |
4. 활용 및 연구분야
| 연구분야 | 내 용 |
|---|---|
|
반도체 |
반도체 도핑 성분 분석 및 증착 성분 깊이방향 분석 |
|
디스플레이 |
디스플레이 표면 성분 분석 및 깊이 방향 분포 확인 |
|
이차전지 |
이차전지 표면 성분 및 잔여물 분석 |
|
품질관리 |
표면 오염물 분석하여 품질 관리에 활용 |